 金牌会员
金牌会员
 已认证
已认证
半导体是现代电子产品的基础,支撑着从计算到数据存储的一切功能。随着器件尺寸缩小且结构日益复杂,精准的失效分析变得至关重要。
AFM-in-SEM 失效分析:该技术直接集成于 FIB / SEM(聚焦离子束 / 扫描电镜)环境,能够在纳米尺度下对半导体元件进行原位、特定位置的电学与形貌表征。它提供精确的电导率映射和掺杂分布分析,同时保持样品完整性。
• 核心优势
特定位置的失效分析: 利用 SEM 精确定位,结合高分辨率电导率与掺杂分布映射。.
无缝真空工作流: 与现有失效分析工具完全兼容,避免表面氧化和污染。.
探针保护与优化接触: 探针坞(Docking Station)在FIB铣削时保护 AFM 探针; 样品旋转功能优化接触角度,适应复杂几何结构。
省时与成本效益: 集成化方案减少单样品测量时间,加速研发进程。
01AFM-in-FIB / SEM 的失效分析流程
样品制备:使用 FIB 暴露缺陷区域。
AFM 导航分析:在 SEM 引导下,AFM 探针定位目标区域进行高分辨率电学表征(如 C-AFM 或 SSRM)。
数据关联:将结果与 SEM 技术关联(必要时校准),全面理解失效机制。

逐层剥离(Delayering): 通过 PFIB 逐层剥离材料,每层进行局部电导率分析,从而精确获取不同深度的单层结构信息。
校准: 对已知掺杂浓度的参考样品进行电阻测量,测得的电阻随后与掺杂水平相关联,生成校准曲线以定量分析掺杂浓度。
02NAND 结构的原位电学失效分析
通过 AFM-in-FIB/SEM 技术,对 NAND 结构中的特定通孔进行以下分析:
识别通孔:使用等离子聚焦离子束(PFIB)逐层剥离材料
电学分析:导电原子力显微镜(C-AFM)映射:显示不同深度节点的电导异常
I/V谱分析:通过单通孔的电流-电压曲线诊断失效
实时监控:在逐层剥离过程中实时观察,确保精确锁定目标通孔
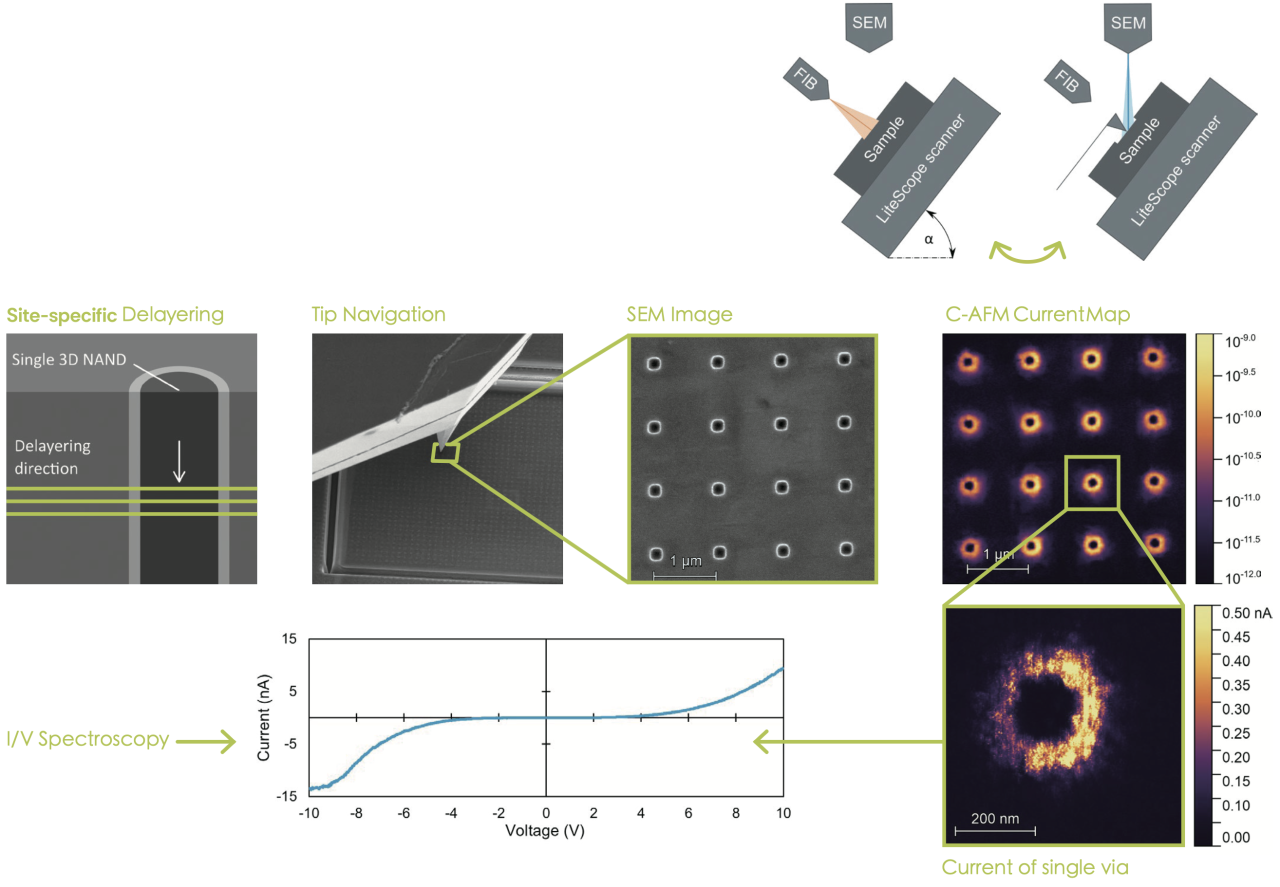
03MOSFET 晶体管的特定位置掺杂浓度分析
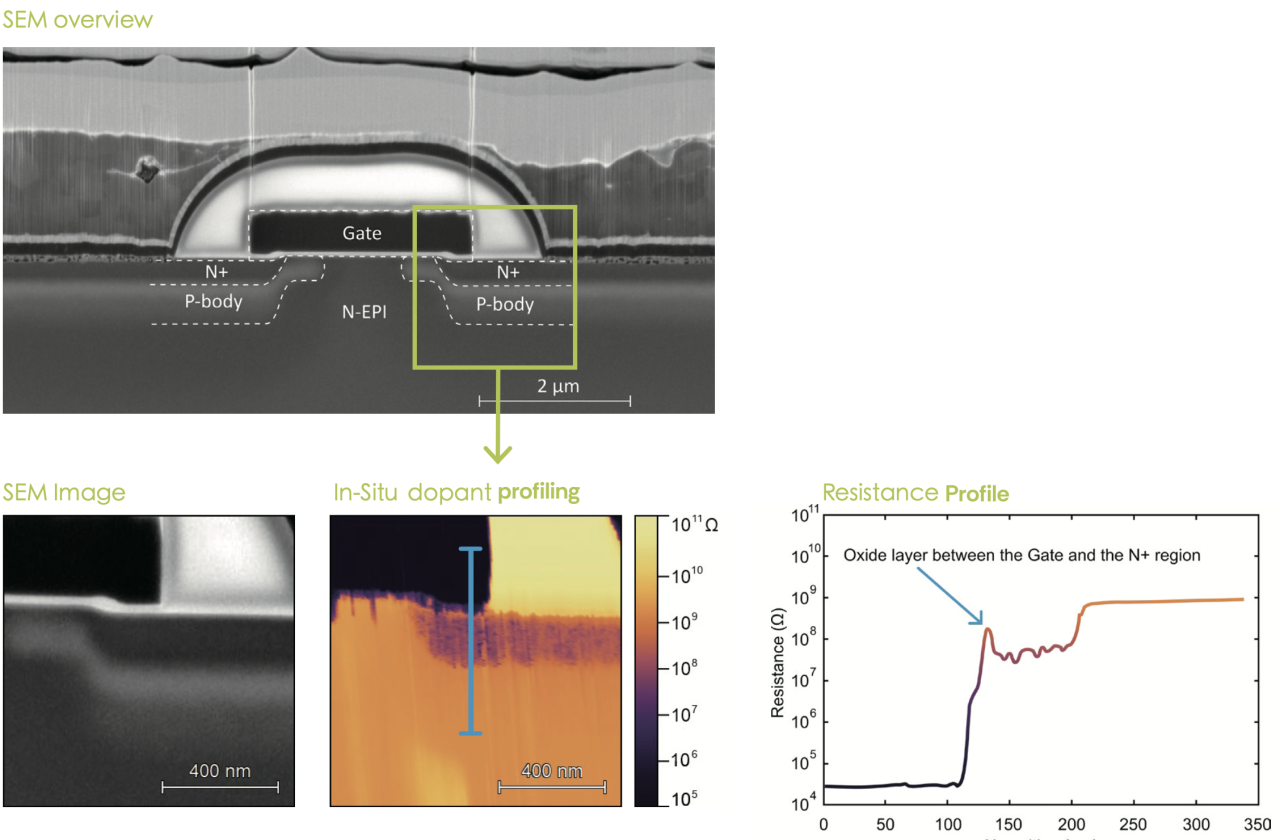
SEM 全局成像:我们采用扫描扩展电阻显微镜(SSRM)结合扫描电子显微镜(SEM),对半导体器件中的掺杂浓度进行了分析,实现了高分辨率、针对特定位置的电学特性表征。
原位 SEM-SSRM 测量:在纳米尺度下映射掺杂浓度,通过将扫描电镜(SEM)成像与局部电学特性相结合,我们能够精确识别出掺杂浓度的空间差异,这些差异对器件的性能表现及可靠性具有决定性影响。
对 SiC MOSFET 的意义:直接表征掺杂层和结区,并分析器件结构的精确形状、尺寸与深度参数。确保导电性优化,减少能量损耗,提升器件可靠性与性能。
04网络研讨会直播预告
更多案例分析,敬请关注 2025 年 5 月 28 日《芯片内部: AFM-SEM 联用技术在电子半导体失效分析中的应用》研讨会。




